Трехмерные микросхемы: TSMC собралась опередить Intel
Taiwan Semiconductor Manufacturing Co. посоперничает с Intel на звание компании, первой выпустившей микросхемы, трехмерная компоновка элементов на которых приведет к тысячекратному повышению плотности упаковки транзисторов на той же площади чипа.
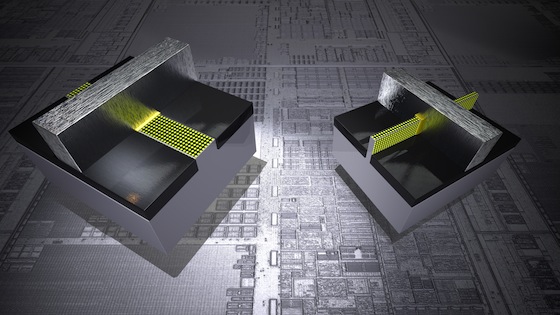
Крупнейший в мире контрактный производитель микросхем готовится к коммерческой сборке первых 3D-чипов еще до конца 2011 года, если верить инсайдерской информации. Планы TSMC совпадают с расписанием Intel, не так давно анонсировавшей технологию микросхем с трехмерными транзисторами — самый большой с 1990-х годов прорыв в разработке чипов.
Объемность достигается упаковкой нескольких слоев кремния в стопки, что приводит к росту производительности на треть при сопутствующем снижении энергопотребления на 50%. Трехмерные микросхемы окажутся востребованными в устройствах, нуждающихся в бережном отношении к собственной автономности, — смартфонах и планшетах. Искомая технология разрешит немало ключевых проблем, стоящих перед производителями в их желании следовать закону Мура: с ростом плотности упаковки транзисторов соединяющие их провода утончаются и все теснее сближаются — в итоге растут сопротивление и перегрев, приводящие к ограничению тактовых частот центральных процессоров.
Выпуск 3D-микросхем не так прост: сложность заключена в проблемах тестирования: допустим, пять кремниевых пластин сложены вместе, и если хотя бы одна из них дефектна, всё изделие уходит в брак. TSMC, в попытках разрешить данную задачу, разработала так называемых двухмерные чипы, которые заменяют органическую подложку на кремний, что повышает показатель транзисторной плотности. Xilinx, производитель коммуникационных микросхем, заказала у TSMC программируемую вентильную матрицу Virtex-7, в которой применяется технология двухмерных чипов с размещением трех пластин на одной кремниевой подложке.
В апреле 2007 года IBM и Политехнический институт Ренсселера при поддержке Управления перспективных исследовательских программ в области обороны анонсировали первые образцы трехмерных микросхем, в которых несколько слоев кремния были объединены при помощи технологии связывания пластин. Исследователи воспользовались кремниевой основой с лежащими поверх активными подложками: в итоге процессор размещается внизу такой стопки, а память и прочие компоненты — вверху. Результатом ставится тысячекратное уменьшение длины соединяющих проводов: данные быстрее передаются, а вычисления ускоряются.
© СОТОВИК